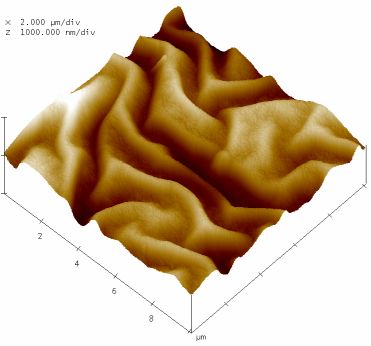
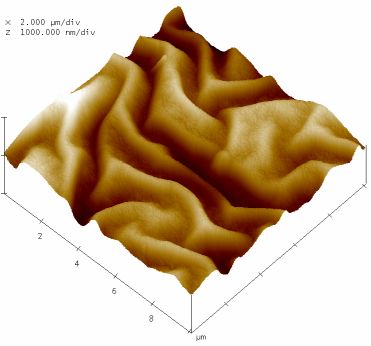 |
|---|
Microscopia de Força Atômica e Tunelamento
Conceitos Básicos (01/02/2013)
Na Microscopia de Força Atômica uma sonda com uma fina
ponta presa à sua haste (cantiléver) interage fisicamente com a superfície de uma amostra por
força de van der Waals durante uma varredura em X,Y. Quando a força é repulsiva, a Microscopia é de Força Atômica de Contato.
Quando a força á atrativa, a Microscopia é de Força Atômica de Contato Intermitente ou de Não Contato. Na Microscopia de Contato,
a força exercida na ponta causa deflexão da haste, que é lida por um laser que reflete nessa haste e chega à fotodetectores (figura a seguir).
Na Microscopia de Contato Intermitente ou de Não Contato, a força exercida na ponta causa uma mudança no RMS do valor
da amplitude do cantiléver oscilante, lida também através da reflexão e detecção de um laser. Qualquer que seja o efeito,
sua alteração depende das diferenças de altura na superfície, que o sistema registra para cada X e Y.

Esquema Básico de Microscopa de Força Atômica
Na Microscopia de Tunelamento, é aplicada uma diferença de potencial entre uma ponta muito fina condutora e uma superfície
condutora ou semi condutora durante uma varredura em X, Y. Quando a distância entre elas é da ordem de 1 nm,
uma corrente de tunelamento é estabelecida, efeito explicado pela física quântica.
A corrente de tunelamento depende exponencialmente da distância entre ponta e superfície.
Assim, no "modo altura", a corrente deve ser mantida constante. Quando a ponta passa por
pontos de diferentes alturas, a corrente é alterada e o sistema de controle a corrige,
sabendo qual foi a distância em z responsável pelo valor alterado na corrente. Para cada ponto X, Y
o sistema então registra Z, formando um mapa topográfico ao final da varredura. No "modo corrente",
a altura é mantida constante e para cada ponto X, Y o sistema registra um diferente valor de corrente,
a qual depende do valor entre superfície e ponta, alterado por irregularidades na superfície, e também dos tipos
de átomos presentes na amostra e do seu arranjo atômico.
Note que essa técnica, diferentemente da Microscopia Eletrônica de Varredura e da Microscopia Óptica, não usa
uma radiação como sonda. A sua resolução acaba sendo definida pela raio da ponta que interage com a superfície da amostra.
A Microscopia de Força Atômica no modo Contato é geralmente utilizada para obter imagens de materiais duros, mas pode ser
até mesmo utilizado para analisar materiais biológicos, utilizandd-se baixo setpoint (ponto de ajuste do cantiléver) e baixa taxa
de varredura. Neste modo geralmente é utilizado um cantiléver de nitrato de silício, cuja deflexão é monitorada durante a varredura
(veja figura 1).
Neste ponto acho importante fazer um intervalo para não deixar dúvidas quanto aos conceitos de chip,
cantiléver e ponta. Veja a figura 2. O chip (figura 2a) tem o mesmo conceito de chip de computador, ou seja,
ele é um bloco microfabricado que contém um dispositivo que cumpre determinada função. Para o AFM, esse bloco tem um tamanho
tal que pode ser manipulado com uma pinça de ponta fina. O dispositivo nesse caso é o cantiléver (figura 2b), onde incide um laser
que faz a leitura de sua deflexão. Um chip pode ter um cantiléver ou alguns cantiléveres, dos quais qualquer um pode ser escolhido.
Na extremidade do cantiléver há uma ponta piramidal (figura 2c), cujo extremo raio, da ordem de 30 nm interage diretamente com a superfície. O resultado desse interação modifica a deflexão do cantiléver.
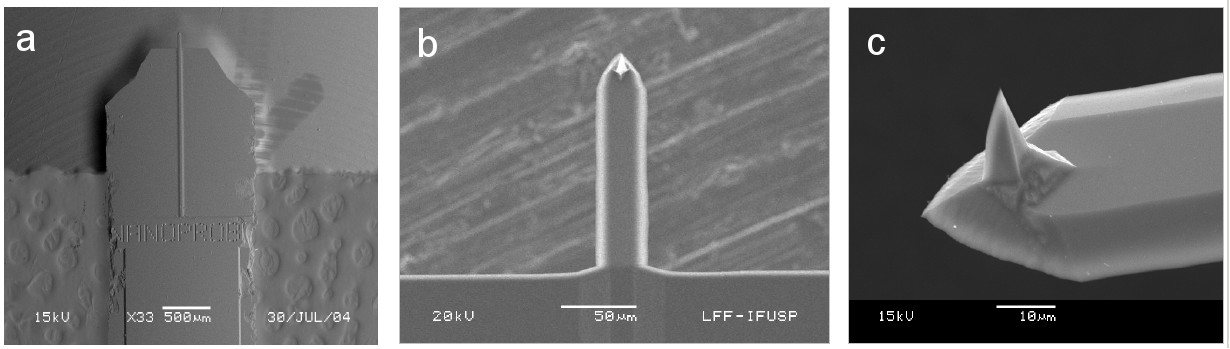
Figura 2 - Microscopia Eletrônica de Varredura mostrando: a) chip; b) cantiléver; c) ponta
Antes de se fazer a imagem, com o cantiléver ainda distante da superfície da amostra, o feixe de laser é colocado sobre o cantiléver de forma a refletir e atingir o fotodetector. Sua posição no cantiléver é ajustada para maximizar o recebimento do sinal no fotodetector. O fotodector transforma o sinal de luz em sinal de voltagem, cujo valor depende da posição do feixe (figura 3) sobre a área do fotector. O fotodector é então movimentado de forma que o sinal de luz chegue bem em seu centro, que significa voltagem 0 V. Portanto, 0 V é associado ao cantiléver sem deflexão. O valor associado à deflexão depende da posição vertical do feixe no fotodetector.

Figura 3 - Algumas posições verticais do laser no fotodetector
O próximo passo é escolher o ponto de ajuste, ou seja, que valor de deflexão do cantiléver deve ser mantido constante durante a varredura.
A deflexão irá ocorrer quando a ponta estiver em contato com a superfície da amostra. Estar em contato significa exatamente dizer que há
uma força repulsiva entre a ponta e a amostra. O quanto o cantiléver está defletido é diretamente proporcional ao valor dessa força.
Assim, quando escolhemos o ponto de ajuste, estamos escolhendo com que força a ponta interage com a superfície da amostra. Um valor típico
é 2 V.
O microscópio então aproxima a ponta da amostra. Ele sabe que há contato entre ponta e superfície quando há a força (ou deflexão)
escolhida pelo ponto de ajuste, dado pela posição vertical do laser no fodetector. Quando isso ocorre, a varredura é iniciada.
Na maioria dos microscópios comerciais, a varredura é feita por um scanner piezoelétrico (existem algumas tipos diversos de configuração,
como tubo e tripod) que movimenta a amostra em pontos x, y, que podem ser, por exemplo 512 x 512 pontos. Em uma topografia, que é o
desenho da superfície da amostra, cada um desses pontos terá uma determinada altura, que modifica o valor de deflexão do cantiléver
assim que a ponta passa por cada um deles. Se foi definido o ponto de ajuste para 2 V, por exemplo, o sistema para manter esse valor
movimenta o scanner na posição z. O sistema conhece qual foi a variação de z e registra esse valor para cada ponto x, y, produzindo a
topografia da amostra. Assim, uma imagem de AFM é um mapa x, y, z, um conjunto de coordenadas espaciais do qual podem ser obtidas muitas informações.
Com esse conjunto podem ser produzidas representações tridimensionais, seções de corte para medir alturas e determinações de rugosidade.